Fokusovaný iontový svazek neboli FIB je zařízení, které vytváří usměrněný tok ionizovaných atomů a fokusuje je na vzorek. Urychlené ionty v místě dopadu a jeho blízkém okolí způsobují vedle dalších procesů i vyrážení atomů z materiálu.
Abstrakt
Práce s fokusovaným iontovým svazkem (FIB) umožňuje nejen mikroobrábění, ale i zobrazování většiny pevných látek v mikro až nanometrovém měřítku, z čehož plyne široký rozsah využití od základního výzkumu až k praktickým aplikacím. Rozvoj této techniky úzce souvisí s rozvojem nanotechnologií a potřebou zobrazovat strukturu látek, obrábět a manipulovat se systémy o rozměrech tisícin až miliontin milimetru. V současnosti se FIB využívá v mnoha oborech od polovodičového průmyslu, forenzních věd, přes geologické, lékařské a biologické aplikace, až po materiálové laboratoře v akademické i komerční sféře. FIB je jedním z nástrojů, jehož rozvoj v posledních letech dává možnost uspokojovat požadavky plynoucí z mnoha nanotechnologických oborů. Cílem této prezentace je představit možnosti mikroobrábění fokusovaným iontovým svazkem, popsat jeho princip a na různých příkladech z naší laboratoře demonstrovat využití především při přípravě vzorků a výrobě mikrosoučástek.
1. Co je to FIB
Fokusovaný iontový svazek neboli FIB je zařízení, které vytváří usměrněný tok ionizovaných atomů a fokusuje je na vzorek. Urychlené ionty v místě dopadu a jeho blízkém okolí způsobují vedle dalších procesů i vyrážení atomů z materiálu. I když lze jako zdroj iontů v principu použít téměř jakýkoli prvek nebo slitinu, většinou jsou preferovány kovy s nízkým bodem tání. Iontové zdroje, které pracují s tekutým kovem, označujeme jako LMIS. Tyto zdroje emitují ionty těžších kovů, které se dají fokusovat do svazku o průměru menším než 10 nm při dostatečné proudové hustotě pro přímé mikroobrábění. Téměř všechny kovy, které mají relativně nízký bod tání a nízkou reaktivitu mohou být využity pro LMIS. V naprosté většině těchto zařízení je zdrojem iontů gallium (Ga). Využití slitin jako zdroje iontů komplikuje nutnost použít hmotnostního separátoru pro zamezení výskytu částic různých hmotností i náboje ve svazku, a tím umožnit fokusaci všech iontů do stejného místa. Preference Ga před jinými prvky je důsledkem řady technických výhod, jež usnadňují konstrukci LMIS. Mezi ně patří například nízká teplota tání (30 °C). Navíc mají ionty Ga relativně vysokou hmotnost aby umožnily vyrážení i těžších prvků, ze kterých může být materiál, a přerušily i silné chemické vazby jako např. v diamantu. Základní porovnání vlastností elektronu a iontu (resp. atomu) Ga je uvedeno v Tab. 1.
Tab. 1 Kvantitativní srovnání iontů ve FIB a elektronů v řádkovacím elektronovém mikroskopu (SEM)
| Atom Ga | Elektron | |
| Průměr částice | 0,27 nm | 0,000005 nm |
| Hmotnost částice | 1,2x10-25 kg | 9,1x10-31 kg |
| Rychlost částic při urychlovacím napětí 30 kV | 280 km/s | 100 000 km/s |
| Rychlost částic při urychlovacím napětí 2 kV | 73 km/s | 26 000 km/s |
| Svazek Ga iontů ve FIB | Svazek elektronů v SEM | |
| Průměr svazku | 100-102 nm | 10-1-101 nm |
| Obvyklé urychlovací napětí | 5-30 kV | 1-30 kV |
| Proud ve svazku | 100 -105 pA | 100 -105 pA |
| Hloubka vniku částice do železa při urychlovacím napětí 30 kV | střední ~11 nm maximální ~30 nm |
střední ~1100 nm maximální ~3500 nm |
2. Další možnosti mikroobrábění
V současnosti je rozvíjející se alternativou k LMIS zdrojům především tzv. plazmový FIB, který vytváří ionty pomocí výboje v plynu. Nejčastěji se používají ionty vzácného plynu xenonu (Xe). Výhoda plasmového FIB spočívá především v možnosti dosažení vysokých proudů (~μA) ve svazku, což spolu s vysokou hmotností Xe iontů vede k rychlejšímu odemílání materiálu. Další výhodou oproti Ga FIB je inertnost Xe iontů, které při interakci s pevnou látkou chemicky nereagují i když se mohou do povrchu implantovat. Vyjmenované výhody Xe FIB jsou ale v porovnání s Ga FIB vyváženy výrazně horší možností fokusace svazku, tj. minimální stopou na vzorku, což ve svém důsledku neumožňuje dosáhnout takového rozlišení v režimu zobrazování (SIM), ani obrábět s takovou přesností jakou nabízí Ga LMIS. Pro úplnost dodejme, že rozlišení plazmového Xe FIB je při 30 kV a nejmenším proudu přibližně ~25 nm, zatímco Ga FIB dosahuje ~5 nm. Využití plasmového Xe FIB je proto vhodné především na „hrubší“ práce k takzvanému „deprocesingu“ v polovodičovém průmyslu a provádění velkých příčných řezů (>100 μm) umožňujících analýzu podpovrchové struktury v materiálovém výzkumu. Takto velké řezy jsou dosažitelné i jinými technologiemi jako např. podstatně rychlejší laserovou ablací, kterou lze stejně jako FIB integrovat přímo do SEM. Nevýhodou laserové ablace je ale výrazně vyšší tepelné zatížení vzorku, které může vést k nežádoucím mikrostrukturním změnám.
V souvislosti s mikroobráběním je zajímavé zmínit i zcela odlišné postupy. V oblasti komerčně dostupných technologií mikroobrábění kovů se lze setkat například s počítačem řízeným elektroerozivním obráběním (EDM) a také třískovým mikroobráběním. Například kruhově symetrické otvory od průměru 20 μm (0,02 mm) lze připravit pomocí vrtání. Jako příklad je na Obr. 1 ukázán otvor o průměru 50 μm vyvrtaný v nástrojové oceli 1.2367.
Z výše uvedeného vyplývá, že hlavní doménou pro využití Ga FIB je obrábění v mikronovém a submikronovém měřítku, kde se zatím nenabízí jiná flexibilnější a univerzálnější technologie, která by byla schopná Ga FIB nahradit.

Obr. 1 SEM snímek otvoru o průměru 50 μm vyvrtaného v nástrojové oceli 1.2367 mikrovrtákem na CNC frézce Fanuc RoboDrill
3. Kdo a kde FIB vyrábí
V současnosti existuje 5 významných dodavatelů FIB. Jedná se o americkou firmu FEI, česko-francouzký Tescan Orsay, německý Zeiss a japonské firmy Hitachi a Jeol. Obr. 2 ukazuje reprezentativní fotky FIB od několika výrobců. Cena zařízení odpovídá technologické náročnosti a know-how potřebného pro jeho výrobu. Tyto skutečnosti spolu s omezeným trhem, který musí zaplatit náklady na vývoj, vedou k počáteční investici řádově od několika set tisíc Euro za základní systém až po několik milionů Euro za plně vybavenou konfiguraci.

Obr. 2 Příklady jednosvazkových, tzv. „single beam“, FIB systémů od několika světových výrobců. Vlevo: plasmový Xe FIB FEI Vion. Uprostřed: Ga FIB Hitachi MI4050. Vpravo: Ga FIB Jeol JIB-4000.
4. Princip FIB
Aby mohl Ga FIB jako celek fungovat, musí obsahovat několik důležitých součástí. Mezi ně patří (Obr. 3):
- iontový zdroj (zásobník Ga, wolframová jehla a extrakční elektroda),
- optická soustava pro zformování svazku (elektrostatické čočky, vychylovací systém svazku a clony),
- komora se stolkem pro umístění a polohování vzorku,
- vakuový systém,
- řídící elektronika (AD/DA převodníky, PC, ovládací hardware a software včetně uživatelského rozhraní).
Přestože se zařízení jednotlivých výrobců liší v mnoha parametrech, rozmístění základních součástí FIB je ve všech případech velmi podobné.

Obr. 3 Umístění jednotlivých komponent v Ga FIB Jeol JIB-4000.
Obr. 4 schematicky znázorňuje uspořádání zdroje a optické soustavy v iontovém tubusu. Během činnosti fokusovaného iontového svazku je Ga samovolně přiváděno v tekutém stavu z ohřátého zásobníku k hrotu wolframové jehly o poloměru několika μm. Mezi špičkou jehly a tzv. extrakční elektrodou je přítomno silné elektrické pole (1010 V/m), které působí ionizaci původně neutrálních atomů Ga. Takto vzniklé ionty jsou následně elektrickým polem vyvedeny vně extrakční elektrody a urychleny na požadovanou energii. Typická urychlovací napětí používaná u FIB jsou v rozsahu od 5 do 30 kV.
Fokusování iontového svazku se nejčastěji dosahuje pomocí dvou elektrostatických čoček. Elektromagnetické čočky běžně používané v optických soustavách elektronových mikroskopů jsou pro tento účel nevhodné, protože intenzita pole potřebná ke změně dráhy částice je úměrná její hmotnosti. Ekvivalentně tomu roste i hmotnost jádra elektromagnetu a velikost proudu nutná k vytvoření takového pole. Vzhledem k rozdílu mezi hmotností elektronu a iontu Ga (Tab. 1), je nepraktické takovéto čočky používat, neboť by vážily tisíce kilogramů.
Proud svazku zpravidla určují clony různého průměru umístěné v optické soustavě. Čím vetší průměr clony, tím více iontů projde a dosáhne se většího proudu. Zároveň se ale zvětšuje i průměr svazku. Typický rozsah proudů u Ga FIB je 1 pA až 60 nA při urychlovacím napětí 30 kV. Ve spodní části optické soustavy je elektrostatický vychylovací systém, který určuje místo dopadu svazku iontů na vzorek. Aby nedocházelo k interakcím iontů s molekulami atmosféry, jinými slovy aby ionty dolétly fokusované až k povrchu vzorku, musí být po celé dráze iontového svazku až k povrchu vzorku vysoké vakuum (typicky ~10-4 Pa v komoře pro umístění vzorku a ~10-5 Pa v iontovém tubusu).

Obr. 4 Schématické uspořádání typické optické soustavy a zdroje v iontovém tubusu
Princip mikroobrábění pomocí FIB spočívá v setrvávání svazku po definovanou dobu (např. 0,3 μs) v určitém místě o souřadnicích [x0, y0], čímž dochází k odprašování atomů materiálu. Po uplynutí nastavené doby se pomocí elektrostatického vychylování svazek přesune do jiné polohy [x1,y1] a proces se opakuje. Pro dosažení požadované hloubky prochází svazek při mikroobrábění opakovaně všemi nadefinovanými body (běžně např. 104 krát). I když je možné obrábět do požadované hloubky jen na jeden průchod svazku, nejsou výsledky z hlediska kvality a přesnosti odprašování uspokojivé v důsledku opětovné depozice vyrážených atomů v okolí místa dopadu svazku. Na Obr. 5 je vidět rozdíl ve kvalitě mikroobrábění čtvercové šablony o straně 2 μm při volbě různých obráběcích strategií. Zatímco čtverec vpravo nahoře byl odprášen na jeden průchod, čtverec vlevo dole byl vyroben 1000 násobným přejetím iontového svazku přes definovanou oblast. Z obrázku je patrná výhoda opakovaných průchodů, která zajistí minimalizaci opětovné depozice odprášeného materiálu. I když je celkový čas odprašování u obou přístupů stejný, v porovnání s opakovanými přejezdy se pro dosažení požadované hloubky při obrábění na jeden průchod musí nastavit výrazně delší doba setrvání svazku v každém bodě šablony.

Obr. 5 Ukázka vymílání čtverce dané hloubky v hořčíkové slitině AZ31 (Mg-3 hm.% Al-1 hm.% Zn) na 1000 průchodů svazku (vlevo dole) a na 1 průchod svazku (vpravo nahoře).
5. Interakce iontů s pevnou látkou
Interakce mezi urychleným iontem a pevnou látkou vede k mnoha žádoucím, ale i k několika nechtěným jevům. Pokud iont pronikne pod povrch pevné látky, prostřednictvím interakcí s atomy postupně ztrácí svou hybnost a kinetickou energii a odchyluje se od původního směru letu. Přenos energie od iontu k atomům v pevné látce vede k množství komplexních procesů zahrnujících například rozptyl iontu na mřížových atomech a jejich vyrážení, emisi elektronů, emisi elektromagnetického (röntgenovského) záření a ohřev vzorku. Urychlený iont se navíc může implantovat pod povrch materiálu, a v některých případech se i chemicky vázat s původními atomy vzorku.
Nejjednodušším modelem pro popis interakce iontů s pevnou látkou je kolizní kaskádní model, ve kterém se kolizní kaskáda rozvíjí prostřednictvím nezávislých binárních srážek iontu s atomy látky. Pokud energie přenesená na vázaný atom překročí určitou mezní hodnotu (vazebná energie), a jedná se navíc o atom blízko povrchu vzorku, může dojít k vyražení tohoto atomu z pevné látky. Jednou z nejrozšířenějších metod simulace binárních kolizí je metoda Monte Carlo implementovaná např. v programu SRIM. Obr. 6 ukazuje příklad interakce mezi iontem Ga urychleným na energii 30 kV a dopadajícím zleva kolmo k povrchu vzorku s hustotou 1736 kg/m3 (hořčík) a 4519 kg/m3 (titan). V tomto modelu závisí hloubka průniku iontu na hustotě a relativním prvkovém složení látky. Čím je hustota materiálu nižší a čím lehčí jsou materiálové atomy v porovnání s dopadajícím iontem, tím hlouběji může iont doletět. Ve skutečnosti závisí hloubka průniku i na dalších parametrech jako je např. orientace krystalové mřížky vůči směru letu iontu. Tento efekt, známý jako kanálování, je v elektronové a iontové mikroskopii zdrojem dodatečného kontrastu a často při pozorování pomocí SEM nebo SIM umožňuje odlišit jednotlivá zrna v polykrystalickém materiálu pomocí různých odstínů šedi. V uvedeném modelu se ale tyto efekty neuvažují. I přes značná zjednodušení, která jsou pro rychlost výpočtů nutná, poskytují tyto simulace neocenitelný nástroj pro modelování interakce mezi urychlenými částicemi a pevnou látkou.

Obr. 6 Simulace trajektorií po dopadu iontu Ga pomocí metody Monte Carlo v programu SRIM-2013. Iont Ga (bílé trajektorie) urychlený napětím 30 kV dopadá zleva kolmo k povrchu Mg (vlevo) a Ti (vpravo) a vyráží v látce vázané atomy (hnědé trajektorie), které, pokud mají dostatečnou energii, mohou také vyrážet další sousední atomy.
6. K čemu se dá FIB využít
FIB sám o sobě umožňuje provádět především velmi přesné a lokalizované vyrážení atomů ze vzorku, a tím postupné vymílání neboli odprašování materiálu dopadem urychlených iontů. Jak lze ale vidět např. na Obr. 18c a 19, v součinnosti s plynovým injektorem umožňuje FIB i depozici materiálů na vzorek (tzv. lokální CVD). S vhodným detektorem lze FIB při nižších proudech použít také pro řádkovací iontovou mikroskopii (SIM) povrchu, stejně jako se využívají elektrony v řádkovacím elektronovém mikroskopu (SEM). Příklad na Obr. 7 ukazuje příčný řez nečistotou na povrchu vzorku, zobrazený pomocí SEM (vlevo) a pomocí FIB (vpravo). Je vidět, že obraz stejného místa poskytnutý elektrony a ionty není identický, ale komplementární. To znamená, že pokud je FIB integrovaný v jednom zařízení společně se SEM, lze toho s výhodou využít pro získávání dalších informací o povrchu a struktuře vzorku. FIB kombinovaný se SEM v jednom zařízení umožňuje i materiálovou tomografii, tj. 3D analýzu materiálu (Obr. 8) a „živé“ pozorování procesu iontového vymílání prostřednictvím elektronového svazku (Obr. 9). FIB zkombinovaný s mikromanipulátorem lze využít nejen pro přípravu nano a mikrostruktur, ale i pro manipulaci s nimi (Jak jinak by se dalo s objektem 10-100x menším než průměr lidského vlasu nakládat?). Obr. 22 v kapitole 10 ukazuje část materiálu odříznutou pomocí FIB a připevněnou k mikromanipulátoru. Z výše uvedeného je vidět, že i když je fokusovaný iontový svazek sám o sobě užitečným nástrojem, v kombinaci s dalším vybavením se výrazně rozšiřují jeho možnosti.

Obr. 7 Příčný řez nečistotou o velikosti ~3 μm, která se nachází na povrchu vzorku. Vlevo: Zobrazení pomocí SEM. Vpravo: stejné místo zobrazené pomocí FIB v režimu SIM. V dolní části obrázku jsou uvedeny některé z nastavených parametrů elektronového resp. iontového svazku. Příčný řez v povrchu vzorku byl vytvořen pomocí FIB při větším proudu, než se používá pro zobrazování. V obou případech byl pro detekci elektronů použit E-T detektor

Obr. 8 3D mikrostruktura superplastické hliníkové slitiny, získaná pomocí tomografické techniky SEM-FIB-EBSD. Každá barva v obrázku reprezentuje odlišnou orientaci krystalové mřížky. FIB se v této technice využívá k odřezávání tenkých vrstev vzorku (zde 100 nm), po nichž vždy proběhlo 2D EBSD mapování. Rekonstrukční software pak ze sady 2D EBSD map vytvoří 3D mapu zkoumané části materiálu.

Obr.9 Video přípravy mikropilíře pro nanomechanické testování kombinuje rotaci a posuv stolku s obráběním pomocí FIB.
Zařízení, které v sobě integruje SEM a FIB, se nazývá dvousvazkový mikroskop, a společně s dalším vybavením umožňuje provádět elektronovou a iontovou mikroskopii s vysokým rozlišením, 2D a 3D analýzy materiálů včetně 3D chemické EDS a krystalografické EBSD analýzy, výrobu mikrosoučástek pro mikro-elektro-mechanické systémy (MEMS), atd. Takto komplexně vybavený systém je instalován ve skupině Objemových nanomateriálů a rozhraní ve Fyzikálním ústavu AV ČR, v. v. i. (Obr. 10).

Obr. 10 Dvousvazkový mikroskop instalovaný ve Fyzikálním ústavu Akademie věd.
Příklady využití FIB uvedené v této kapitole nezahrnují zdaleka všechny jeho možnosti ale pouze nastiňují jeho „spoluúčast“ při různých technikách analýzy mikrostruktur. S ohledem na zaměření článku se text bude dále zabývat výhradně využitím dvousvazkového mikroskopu pro přímé mikroobrábění materiálů. Související „výrobní“ techniky jako FIBem indukovaná depozice nebo obrábění za asistence leptacího prekurzoru nejsou v této práci popsány a čtenáře odkazujeme na odborné publikace uvedené v závěru této práce.
7. Jaké má FIB možnosti mikroobrábění
Velikost objektů, které je možné iontovým svazkem „vytvářet“, se pohybuje řádově od 50 nm do 100 μm. Optimální rozměry jsou ale mezi 500 nm a 50 μm. Objekty menší než 500 nm kladou zvýšené požadavky na stabilitu systému, kvalitu iontového svazku a zkušenosti obsluhy. Větší objekty (nad 100 μm) jsou značně náročné časově a množství odprášeného materiálu může mít nepříznivý vliv na komponenty ve vakuové komoře mikroskopu (např. znečištění detektorů). Pro obrábění takto velkých objektů existují jiné a efektivnější technologie. Některé z nich jsou zmíněné v Kap. 2.
Přesnost vymílání pomocí FIB závisí nejen na parametrech svazku, ale i na definici přesnosti. Je-li do materiálu například vyroben kruhový otvor, je jeho kruhovitost často lepší, než lze změřit pomocí SEM (Obr. 11). Vychylování svazku je totiž řízeno elektrostaticky a nikoli mechanicky, a proto lze svazek polohovat v rozsahu několika stovek μm s vysokou přesností. Při mikroobrábění iontovým svazkem obecně platí, že čím je vyšší proud svazku, tím je rychlejší mletí, ale nižší kvalita opracované plochy a naopak.
Všimněte si světlejšího okraje otvoru v levé horní části na Obr. 11. Tento jev není způsoben nepřesností v obrábění, ale asymetricky (tj. mimo osu elektronového svazku) umístěným detektorem elektronů (E-T detektor), který detekuje různé množství elektronů v závislosti na orientaci hrany – tzv. hranový efekt.

Obr. 11 Kruhový otvor o průměru 4,5 μm vymletý pomocí FIB do tenké folie tloušťky 1,5 μm, vyrobené z hliníkové slitiny. Otvor společně s folií tvoří interferometr použitý k měření fázové deformace vlnoplochy rentgenového laseru provozovaného v laboratoři PALS.
Velikost vzorku vhodného pro výrobu mikrosoučástek, nebo mikroobrábění obecně, je v principu omezena pouze velikostí komory, případně i rozsahem posuvů stolku se vzorkem. Manipulace s velkými vzorky v komoře mikroskopu plné detektorů a dalšího vybavení je ale značně riziková z důvodu možné kolize. Z tohoto důvodu je za optimální považován vzorek do velikosti uzávěru PET láhve.
Pomocí FIB lze obrábět prakticky libovolný materiál, který je odolný vůči nízkému tlaku v komoře mikroskopu (~10-4 Pa). Může se jednat o kovy, polovodiče, keramiky, plasty nebo biologické vzorky. Problémem nejsou ani tvrdé materiály včetně diamantu. Určité komplikace mohou způsobovat vícefázové mikrostruktury, v nichž se jednotlivé fáze mohou vymílat různou rychlostí.
Představme si nyní mikrosoučástku o velikosti např. 10 μm. Jaké jsou požadavky na strukturu materiálu, ze kterého je vyrobena? Teď nehovoříme o chemickém složení, ale o struktuře, především velikosti zrna. V některých učebnicích o materiálech se lze (i když jen zřídka) dočíst, že velikost zrna by měla být alespoň o dva řády menší než je velikost součástky, aby se materiál při mechanickém namáhání jevil jako homogenní a s reprodukovatelnými vlastnostmi. Máme-li tedy součástku o velikosti 10 μm, pak velikost zrna v materiálu by měla být nejvýše 100 nm. Materiály s takto „jemnou“ strukturou se označují jako ultrajemnozrnné a nanokrystalické, a jejich příprava vyžaduje speciální technologické postupy. Druhou možností je použít pro výrobu mikrosoučástek vhodně orientované monokrystaly. Právě vývojem a charakterizací výše uvedených tříd materiálů se v Oddělení progresivních strukturních materiálů zabýváme. I když je volba materiálu vhodného pro přípravu mikrosoučástky z hlediska jeho struktury a složení velmi důležitá, přesahuje rámec této práce, a proto nebude tomuto tématu v dalším textu věnována pozornost.
Až doposud bylo řečeno, k čemu je možné FIB použít. Každé zařízení má ale kromě výhod, kvůli kterým nachází uplatnění, i nevýhody. Ty jsou objektivně shrnuty v Tab. 2.
Tab.2 Výhody a nevýhody FIB.
| Výhody | Nevýhody |
| Vysoká přesnost (~10 nm). | Nutnost vysoce kvalifikované obsluhy. |
| Možnost obrobení prakticky jakéhokoli materiálu (v kombinaci s kompenzací náboje pomocí SEM i nevodivých vzorků, např. diamantu). | Vysoká pořizovací cena a provozní náklady se promítají do vysoké ceny mikroobrábění. |
| Možnost výroby mikrosoučástek o velikosti 100 nm - 100 μm. | Možnost kontaminace obráběného povrchu galliem a depozice odprášeného materiálu v okolí. |
| Ve spojení s dalším příslušenstvím se jedná o univerzální zařízení pro přípravu mikro-elektro-mechanických systémů (MEMS). | Iontový svazek při dopadu na materiál působí vždy destruktivně, tedy i během iontové mikroskopie. |
| Malé poškození povrchu ve srovnání s mechanickým obráběním. | Nevhodné pro sériovou výrobu. |
8. Schéma dvousvazkového mikroskopu a jeho ovládání
Obecné schéma uspořádání svazků ve dvousvazkovém mikroskopu je na Obr. 12. Iontový a elektronový svazek jsou vůči sobě skloněny o přibližně 50°. Na rozdíl od samostatných FIB systémů (Obr. 2), kde je iontový tubus umístěný vertikálně, je ve dvousvazkových mikroskopech ve většině případů vertikální SEM tubus a iontový tubus je skloněný. Důležité je, že elektronový a iontový svazek nejsou paralelní, ale protínají se v takzvaném koincidenčním bodě. Obrábíme-li cokoli v koincidenčním bodě iontovým svazkem, můžeme to samé místo pozorovat elektronovým svazkem. Stolek ve dvousvazkových mikroskopech má obvykle 5 stupňů volnosti (posuvy x, y, a z; rotace; náklon). Vhodným nastavením tak můžeme vzorek vždy polohovat do vhodné orientace pro současné pozorování a vymílání. Možnost vymílání materiálu pomocí iontového svazku a zároveň pozorování procesu elektronovým svazkem naživo přináší mnoho výhod . Lze tak například kontrolovat v reálném čase proces vymílání a v případě potřeby upravit nastavené parametry.

Obr. 12 Schéma uspořádání svazků ve dvousvazkovém mikroskopu SEM-FIB.
Celé zařízení je zpravidla ovládáno několika počítači, každý pro určitou část mikroskopu. Například analytické techniky jako EBSD mají z důvodu vysoké výpočetní náročnosti vlastní PC. Po vložení vzorku do komory mikroskopu a jejím vyčerpání na tlak ~10-4 Pa probíhají veškerá nastavení přes uživatelské rozhraní na řídicím počítači. Hlavní uživatelské rozhraní dvousvazkového mikroskopu FEI Quanta 3D FEG, ze kterého se nastavuje i FIB, je vidět na Obr. 13. Kromě lišt a záložek pro nastavení parametrů je uživatelské rozhraní rozděleno na 4 zobrazovací okna (tzv. kvadranty). V každém kvadrantu jsou v dolní části uvedeny základní nastavené parametry svazku a mikroskopu: HV = urychlovací napětí, Curr = proud svazku, WD = pracovní vzdálenost mezi koncem elektronového resp. iontového tubusu a povrchem vzorku, det = typ použitého detektoru, a zcela vpravo měřítko.

Obr. 13 Uživatelské rozhraní (UI) dvousvazkového mikroskopu FEI Quanta 3D FEG, ze kterého se ovládá SEM, FIB a další časti mikroskopu. Vlevo nahoře: Snímek ze SEM (vzorek vymílaný pomocí FIB s vrstvou nanesené platiny). Vpravo nahoře: Snímek ze SIM, tj. zobrazení iontovým svazkem (tenká folie s rozměry ~0,01x0,006x0,001 mm3 připevněná k mikromanipulátoru a vyzvednutá nad povrch vzorku). Vlevo dole: Navigační mapa celého vzorku poskládaná z jednotlivých SEM snímků. Vpravo dole: Pohled infrakamerou na vnitřek komory mikroskopu.
9. Co lze pomocí FIB vyrobit? Část I.
V následující kapitole jsou uvedeny příklady mikroobrábění pomocí dvousvazkového mikroskopu instalovaného v laboratoři skupiny Objemových nanomateriálů a rozhraní Fyzikálního ústavu Akademie věd. Tvar, který chceme vyrobit pomocí FIB, je možné zadat několika způsoby. Využít lze přednastavených šablon, importovaných bitmap, nebo je možné přímo programovat pohyb iontového svazku bod po bodu. Ať je vstupní formát jakýkoli, vždy je softwarem ve FIB převeden na sérii instrukcí, která obsahuje souřadnice místa dopadu svazku na vzorek [xi, yi] , dobu setrvání svazku v tomto místě, počet průchodů svazku a směr pohybu svazku. U bitmapy a přímého programování pohybů je pochopitelně nutné pro správnou interpretaci dodržet požadavky na formát dat.
Pro začátek je nejjednodušší využít přednastavených geometrických šablon typu kruh, obdélník, mnohoúhelník, úsečka, atd. Po nastavení napětí a proudu iontového svazku, fokusaci na vzorek a korekci astigmatismu, je nutné pořídit náhledový snímek rychlým přejezdem FIB přes zobrazovanou oblast. Tím zkontrolujeme správnost nastavení svazku, pozici vzorku a zároveň dostaneme snímek povrchu, z jehož části budeme odprašovat materiál iontovým svazkem. Dále je nutné vybrat požadovaný geometrický tvar z nabídky, přenést jej na materiál ve správné velikosti a na správné místo pomocí myši, a proces mikroobrábění může začít. Obr. 14a a 14b ukazují trojúhelník o velikosti ~ 4 μm a „pokus“ o čtyřcípou hvězdičku velikosti ~ 2 μm vymleté do monokrystalu křemíku. Doba vymílání těchto vzorů se pohybovala v rozmezí desítek sekund až jednotek minut. Oba obrázky byly získány pomocí SEM po dokončení iontového vymílání. Z Obr. 15 je patrné, že mikroskop umožňuje vymlít i více přednastavených tvarů najednou.

Obr. 14 SEM snímky jednoduchých tvarů vymletých do monokrystalu křemíku pomocí FIB. Vlevo: Pohled shora. Vpravo: Pohled na povrch vzorku pod úhlem 52°.

Obr. 15 SEM snímek sestavy dvou kruhových a jedné obdélníkové šablony vymletých najednou do povrchu integrovaného obvodu.
Vzor na Obr. 16 vznikl modifikací přednastavené šablony obdélníku s tím rozdílem, že systému byl zadán pohyb v rastru s krokem větším, než je průměr svazku. Výsledkem je síť otvorů s roztečí přibližně 80 nm.

Obr. 16 SEM snímek matice otvorů s rozestupy přibližně 80 nm.
Podobně jako soustavu dírek lze modifikací parametrů přednastavené kruhové šablony získat soustavu soustředných kružnic (Obr. 17). Průměr největší z nich je ~800 nm. Pro úplnost dodejme, že vzory na Obr. 16 a 17 jsou vymlety v monokrystalu křemíku.

Obr. 17 SEM snímek soustředných kružnic. Průměr největší z nich je asi 800 nm.
10. Co lze pomocí FIB vyrobit? II. Část
V následujícím textu si ukážeme některé příklady komplexního mikroobrábění pomocí naprogramovaných skriptů, které mohou ovládat nejen FIB, ale i koordinovat činnosti ostatních částí mikroskopu (např. stolek se vzorkem, GIS, SEM). Skripty lze psát v libovolném textovém editoru, který dokáže ukládat text ve formátu „plain text“. Soubory se skripty se následně nahrají do ovládacího softwaru mikroskopu a spustí se jejich vykonávání.
Pro testování nanomechanických vlastností materiálů se používají vzorky ve tvaru mikropilířů, které jsou namáhány jednoosým tlakem pomocí nanoindentoru s plochým diamantovým hrotem. Tyto vzorky se nejčastěji připravují vymletím do povrchu materiálu pomocí FIB. Nejjednodušší strategií je modifikace šablony kruh. Zadáním vnějšího a vnitřního poloměru vznikne mezikruží, jehož odprášením dostaneme požadovaný tvar. Jak lze vidět z Obr. 18a, výsledek není uspokojivý z hlediska zvětšujícího se průměru mikropilíře od povrchu směrem k základně. Rafinovanější procedura zahrnuje vymílání ionty Ga, které v tomto případě nedopadají kolmo k povrchu, ale pod určitým úhlem, a je spojena s postupným otáčením stolku po pravidelných úhlových krocích. Řídící skript zahrnuje ovládání FIB a stolku se vzorkem, a hojně využívá software pro rozpoznávání obrazu. Ten je schopen pomocí detekce referenční značky po každém mechanickém pootočení stolku přesně korigovat jeho pozici (Obr. 18c). Při otáčení stolku se vzorkem iontový svazek na vzorek nedopadá, ale je odkloněn. Po každém pootočení a nadefinované čekací době nutné ke stabilizaci mechanického stolku proběhne jeden rychlý kontrolní přejezd iontového svazku po povrchu vzorku spojený s detekcí elektronů vyražených skenujícími ionty. Výsledkem je iontový obraz (SIM), ve kterém software hledá referenční značku. Po jejím nalezení provede korekci polohy iontového svazku a systém pokračuje ve vymílání mikropilíře. Výsledkem odladěného skriptu je automatizovaná příprava mikropilířů bez nutnosti zásahu obsluhy. Jak je patrné z Obr. 18b, rozdíly v průměru vzorku u povrchu a u základny jsou při této technice minimální. Na druhé straně některé publikace upozorňují, že implantace ionty Ga je při použití této techniky vyšší, než např. při vymílání pomocí mezikruží. Implantace ionty může nepříznivě ovlivnit hodnoty mechanických vlastností, které pak nepopisují mechanickou odezvu původního materiálu, ale materiálu modifikovaného Ga.

Obr. 18 Mikropilíře s průměrem <3 μm v čistém monokrystalickém hořčíku s krystalovou orientací (0001), připravené pomocí dvou různých FIB technik: a) vymíláním mezikruží (nejjednodušší způsob); b) „soustružením“ pomocí FIB (náročnější postup). c) Vzorek z obrázku (b) při malém zvětšení. Malý kruh vlevo uprostřed vymletý pomocí FIB do čtverce z platiny nadeponované pomocí FIB a Pt GIS je referenční značka, která slouží k polohování vzorku pomocí rozpoznávání obrazu. „S2-1“ je označení vzorku vymleté pomocí FIB. Tvar odprášeného materiálu kolem mikropilíře umožňuje pozorování pomocí SEM při deformaci nanoindentorem.
Jednostranně vetknutý mikronosník je dalším mikroobjektem, který slouží k testování mechanických vlastností, a který lze připravit pomocí FIB. V tomto případě dochází k namáhání ohybem a testování se opět provádí nanoindentorem. Na Obr. 19 je mikronosník vyrobený v jedné z fází cementové pasty. Čtvercový nebo kruhový průřez nelze pomocí FIB v této orientaci technicky realizovat protože podélná osa mikronosníku je rovnoběžná s povrchem. Proto byl zvolen trojúhelníkový profil, který lze pomocí FIB připravit relativně snadno. Tak jako v předchozím příkladu bylo i zde využito polohování svazku pomocí rozpoznávání obrazu, a to nejen pro výrobu jednotlivých mikronosníků, ale i k jejich dávkové přípravě na různých místech vzorku. Pro relevantní zhodnocení nanomechanických vlastností nestačí testovat pouze jeden mikronosník, ale je potřeba mít určitá statistická data, aby se eliminovala chybná měření. Doba, kterou trvá výroba jednoho mikronosníku, je přibližně 30 minut. Celkem bylo v cementové pastě vyrobeno několik desítek mikronosníků. Pro úplnost je na Obr. 20 záznam z testování mikronosníků připravených pomocí FIB natočený pomocí SEM.

Obr. 19 Mikronosník připravený v jedné z fází cementové pasty. Cílem bylo zjistit rozdíly mechanických vlastností jednotlivých fází, ze kterých je pasta složena. Referenční značka ve tvaru písmene H na obrázku vpravo je vymletá pomocí FIB do nadeponovaného Pt čtverce a slouží pro softwarové rozpoznávání obrazu.
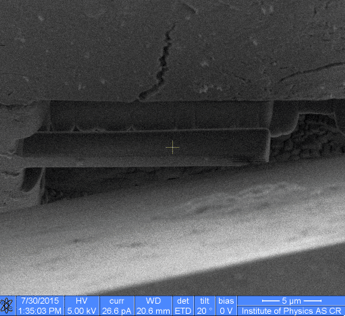
Obr. 20 Záznam z testování mikrotrámečku pomocí nanoindentoru umístěného v komoře dvousvazkového mikroskopu (tzv. in situ nanoindentace). SEM umožňuje pozorovat a zaznamenávat průběh deformace pro případnou korelaci videa s deformačními daty. Zvýšené hodnoty šumu jsou důsledkem vysoké obnovovací frekvence elektronového obrazu, aby video bylo plynulé. Trhavý pohyb videa je způsoben kompresí originálního souboru nikoli malou řádkovací frekvencí SEM.
Pro úplnost a dokreslení představy o kódu uvádíme níže i část naprogramovaného skriptu pro automatizovanou výrobu mikronosníku z Obr. 19. Celý program má přibližně 500 řádků.

Zajímavým uplatněním FIB je výroba součástek pro mikro-elektro-mechanické systémy (MEMS), a v případě dvousvazkového mikroskopu vybaveného GISy a mikromanipulátorem i možnost montáže celých MEMS. Typickým příkladem MEMS jsou gyroskopy, turbíny, aktuátory a převodovky o velikosti jednotek až stovek mikrometrů. Abychom ověřili možnost přípravy MEMS pomocí FIB a mohli studovat efekty plynoucí z miniaturizace, byly napsány skripty pro generování tvarů a automatizovanou přípravu evolventního ozubení. Cílem je ověřit kvalitu obrábění pomocí FIB a jeho limity ve vztahu k velikosti koleček a geometrii ozubení. Obr. 21 ukazuje ozubená kolečka průměru ~4 μm vymletá v čistém monokrystalickém Mg s orientací krystalové mřížky (0001). Volba orientace materiálu a jeho struktura mají zásadní vliv na mechanické vlastnosti. Dalším důležitým faktorem je i množství zubů, které lze při daném průměru pomocí FIB vyrobit a to jak z hlediska technologického (průměr svazku, rozlišení posuvů svazku), tak i materiálového (zajištění optimálních mechanických vlastností a integrity materiálu).

Obr. 21 Evolventní ozubená mikrokolečka vyrobená pomocí FIB v monokrystalu hořčíku s orientací (0001). Počet zubů: 5 (vlevo), 20 (uprostřed), 30 (vpravo).
Obr. 22 ukazuje tenkou fólii vyrobenou v integrovaném obvodu, která bude použita k výzkumu mikrostruktury v transmisním elektronovém mikroskopu (TEM). Fólie byla připravena na základě naprogramovaného skriptu v plně automatizovaném režimu mikroskopu. Při ní musí systém koordinovat SEM, FIB, GIS a pohyby stolku se softwarovým rozpoznáváním obrazu. Rozpoznávací systém se orientuje podle dvojice referenčních značek (křížků), které na obraze hledá a podle nichž koriguje polohu vzorku a svazku tak, aby bylo při výrobě fólie dosaženo požadované přesnosti. Tloušťka fólie ve střední části je ~150 nm. Po nastavení systému trvá samotná příprava takovéto fólie přibližně 20 minut.

Obr. 22 SEM snímek TEM fólie v křemíkové polovodičové součástce. Pohled na vzorek pod úhlem 52° (vlevo) a ze shora (vpravo).
TEM fólie je možné připravovat buď v plně automatizovaném režimu jako na Obr. 22, nebo je možná manuální příprava operátorem mikroskopu. Obr. 23 ukazuje vzorek supravodivého materiálu odříznutý pomocí FIB, ze kterého bude postupným manuálním ztenčováním (také pomocí FIB) vyrobena fólie pro TEM. Vzorek je pomocí FIB a GIS připájen k mikromanipulátoru, přenesen k držáku (standardní 3 mm držák TEM folií) a odříznut od špičky hrotu mikromanipulátoru. Pro pájení byl použit GIS s náplní na bázi platiny. Aby nedošlo k záměně vzorků, je pomocí FIB na držák vyryto identifikační číslo. Oproti předchozím obrázkům je snímek na Obr. 23 pořízen ionty (SIM) a nikoli elektrony (SEM). Důvodem byla v danou chvíli lepší orientace vzorku vůči iontovému svazku oproti elektronovému. Jak již bylo zmíněno, SIM je vhodné provádět při nižších proudech iontového svazku. Z popisků v dolní části Obr. 23 lze vyčíst, že se v tomto případě jednalo o proud 10 pA. Pro samotné mikroobrábění byly použity proudy 50 pA-3 nA.
Příprava vzorků pro TEM pomocí FIB je často využívanou technikou. Její velkou výhodou je, že se vzorek pro pozorování v TEM připravuje přesně z místa, které si předtím vybereme pomocí SEM. Může se jednat např. o nějakou poruchu na povrchu materiálu, kterou potřebujeme dále analyzovat.

Obr. 23 SIM snímek (tj. FIB použitý jako řádkovací iontový mikroskop) povrchu vzorku, ze kterého bude postupným tenčením vyrobena fólie pro TEM.
11. Slovo závěrem
Pokud Vás problematika využití FIB zaujala, můžete se aktivně zapojit formou bakalářských, diplomových či doktorských prací. Další informace a kontakty lze nalézt na stránkách skupiny Objemových nanomateriálů a rozhraní. Tato práce vznikla s cílem přiblížit tuto stále ještě exotickou technologii zájemcům z řad studentů, inženýrů, techniků a vědců. V textu byly využity následující zdroje:
- N. Yao (ed.), Focused Ion Beam Systems: Basics and Applications, Cambridge University Press, Cambridge, 2007.
- L.A. Giannuzzi and F.A. Stevie (eds.), Introduction to Focused Ion Beams: Instrumentation, Theory, Techniques and Practise, Springer, New York, 2005.
- J. F. Ziegler, SRIM-2013, http://www.srim.org/
- Mnohaleté zkušenosti autora a kolegů s technologií FIB. Všechny mikroskopické obrázky pocházejí z dvousvazkového mikroskopu FEI Quanta 3D FEG provozovaného naší skupinou.
Rád bych na tomto místě poděkoval členům naší skupiny, zejména L. Polívkovi a J. Bočanovi za korekce, podněty a některé obrázky. Budu vděčný i za jakékoli konstruktivní připomínky z řad čtenářů, které povedou ke zlepšení textu.