LABORATOŘ
POLOVODIČOVÝCH
|
LABORATOŘ
POLOVODIČOVÝCH
|
Slyšíme-li slovo polovodič, vybaví se nám křemík, materiál, z něhož jsou
vyrobeny součástky v našich elektronických zařízeních jako jsou rádia, televizory,
počítače, mobilní telefony, MP3 přehrávače, GPS navigace a další. Svítivé diody
LED v těchto zařízeních, ale i klíčové součástky v mnohých z nich, jako
např. polovodičové lasery v přehrávačích kompaktních disků, laserových
tiskárnách a v komunikačních spojích mezi počítači i kontinenty, součástky v
přijímačích satelitní televize či v nejrychlejších počítačích, jejich
pamětech a též fotovoltaické články používané v kosmu jsou vyrobeny ze
sloučeninových polovodičů typu AIIIBV, eventuálně AIIBVI
nebo AIVBVI (římská číslice označuje sloupec periodické
tabulky, ve kterém se prvek nachází). Nejtypičtějším a nejpoužívanějším
představitelem polovodičů AIIIBV je arsenid gallitý (GaAs).
Křemík totiž "neumí" svítit a je i pomalejší a méně účinný jako detektor
či fotočlánek.
Prvky, které lze použít pro přípravu sloučeninových polovodičů, jsou označeny
v periodické tabulce na následujícím obrázku.
|
Periodická tabulky prvků s vyznačenými stavebními |
Na dalším obrázku jsou do grafu vyneseny téměř všechny používané sloučeninové polovodiče. X-ovou osu grafu představuje mřížková konstanta a0, Y-ovou osou je šířka zakázaného pásu Eg. Body odpovídají jednotlivým binárním sloučeninovým polovodičům, spojnice mezi body polovodičům ternárním (např. InGaAs mezi GaAs a InAs). Jedna výhoda sloučeninových polovodičů je přímo z tohoto grafu zřejmá: máme na výběr množství materiálů s různými šířkami zakázaného pásu a různými mřížkovými konstantami. Jestliže používáme kvaternární polovodiče (např. InGaAsSb), můžeme se pohybovat v grafu i po ploše mezi čarami a získáme tak ještě větší volnost při výběru těchto parametrů, Můžeme tak zvolit materiál, který má stejnou mřížkovou konstantu jako dostupná podložka binárního polovodiče (GaAs, InP, GaSb) a zároveň požadovanou šířku zakázaného pásu ( ta udává vlnovou délku vyzařovaného světla), nebo index lomu či jiné optické a elektrické vlastnosti.
Badatelský zájem se se zavedením heterostruktur začátkem sedmdesátých let posunul na sloučeninové polovodiče, což umožnilo vznik nového oboru -- optoelektroniky, spojeného s objevem polovodičového laseru v r. 1962. Výzkum těchto polovodičů vedl samozřejmě i k jejich využití v klasické doméně křemíku, kde umožnily např. zvýšit mezní frekvenci a výkon tranzistorů. Hlavní výhodou těchto polovodičů je však možnost přípravy heterostruktur, využívajících kombinaci vhodných vlastností různých polovodičů.
Práce dvou týmů fyziků oceněných Nobelovými cenami objasnily i chování uměle vytvořených struktur, možných jen v těchto polovodičích: supermřížek (Esaki 1970) a kvantových jam (Klitzing 1980). Nakonec bylo toto cenou odměněno i zavedení heterostruktur (Alferov a Kroemers 2000). Využití těchto struktur v praxi vedlo k dalšímu výraznému zlepšení parametrů praktických součástek a k urychlenému vývoji technologií schopných takovéto struktury připravovat. Současně se však ukázalo, že je třeba dalšího intenzivního výzkumu, aby bylo možno porozumět chování těchto struktur a také rozšířit využití jejich vlastností.
Technologiemi vhodnými pro přípravu heterostruktur i na úrovni nano- jsou epitaxe z molekulárních svazků MBE (zavedená zkratka anglického Molecular Beam Epitaxy) a plynná epitaxe z organokovových sloučenin MOVPE (z anglického Metal-Organic Vapor Phase Epitaxy). MOVPE se většinou užívá v Evropě, v Americe a Asii se užívá MOCVD (z anglického Metal-Organic Chemical Vapor Deposition). MBE je klasická badatelská technologie, vyžadující ultravysoké vakuum, je vhodná pro studium jednoho typu polovodiče a není příliš vhodná pro masovou či velkoplošnou výrobu. Termín epitaxe zavedl v roce 1936 L. Royer a pochází z řeckých slov epi (nad) a taxos (uspořádaně).
MOVPE je technologie, dávající prakticky stejné výsledky jako MBE, ale umožňující snazší změnu připravovaného materiálu a dávající podstatně vyšší výrobní výkon, vhodný i pro průmyslové využití. Její rozvoj byl závislý na dostupnosti široké škály organokovových sloučenin v extrémní čistotě a na porozumění složitého procesu tvorby vrstev, při němž hrají značnou roli i chemické reakce v těsné blízkosti vznikající vrstvy a hlavně děje na povrchu.
MOVPE využívá pro epitaxi polovodičů atomy prvků uvolněné tepelným rozkladem molekul zdrojových sloučenin (prekursorů) - organokovovů a hydridů, jako jsou např. trimethygallium, tertiarybutylarsín nebo arsín. Schematicky jsou tyto molekuly znázorněny na obrázku.
|
|
|
Schematické znázornění některých molekul prekursorů pro MOVPE technologii. |
Zjednodušené schéma aparatury MOVPE. |
V čem spočívá princip technologie MOVPE? Na obr. 4. se nachází
zjednodušené schéma MOVPE aparatury. Polovodičový substrát je zahříván podobně
jako u MBE, není však umístěn ve vakuu, ale v reaktoru, kterým protéká směs
plynů. Největší podíl ve směsi má nosný plyn, kterým je většinou dokonale
čistý vodík čištěný difusí přes stěnu palladiové trubičky až na čistotu
lepší než 1 ppb (1 molekula nečistoty na 109 molekul vodíku). Někdy se též
používá jako nosný plyn dusík N2 či směs H2 + N2.
Do nosného plynu jsou přimíchány molekuly obsahující atomy potřebné pro epitaxi
požadovaného polovodiče. Sloučeniny, jejichž molekuly obsahují atomy potřebných
chemických prvků se nazývají prekursory. Některé prekursory jsou za normálních
podmínek plyny a uchovávají se v tlakových láhvích, jiné jsou kapaliny nebo pevné
látky, ty se nacházejí v nerezových láhvích, tzv. bublačkách. Kapalným
prekursorem probublává vodík (případně jiný nosný plyn), který se tak nasytí
parami prekursoru a transportuje je systémem tenkých nerezových trubiček, ventilů a
regulátorů průtoku do reaktoru. Všechny nerezové součástky přicházející
do styku s prekursory musí mít leštěný vnitřní povrch, aby se na něm co nejvíce
omezila adsorpce prekursorů. Jejich následné uvolňování po přepnutí na růst
jiného materiálu by způsobovalo neostrost (nestrmost) heterogenního rozhraní, což by
někdy mohlo zhoršit fyzikální vlastnosti struktury.
Představme si například, že chceme připravit GaAs vrstvu a na ni pokračovat vrstvou
AlGaAs. Substrát z GaAs musíme nejprve předehřát asi na 650 až 700 °C. Aby
desorbovaly oxidy gallia a arzénu, případně další povrchové nečistoty a také se
při této teplotě povrch substrátu prakticky monoatomárně hladce vyrovná. Do
nosného plynu přimísíme molekuly obsahující atomy Ga a As. Nejjednodušší
organokovový prekursor Ga je sloučenina trimethylgallium (používá se zkratka
TMGa). Nejvíce používaný As prekursor je arsín (AsH3), což je
velice jedovatý plyn. Proto musí být každá MOVPE aparatura
používající tento plyn k epitaxi několikanásobně zabezpečena proti případnému
úniku sebemenšího množství tohoto plynu. Máme tedy připraveny plyny H2,
TMGa a AsH3. Množství těchto plynů se musí přesně nastavit pomocí
regulátorů průtoku a pak dokonale promísit v tzv. mísící hlavě na vstupu do
reaktoru, aby z ní do reaktoru vstupovala již homogenní směs, jinak by totiž
mohla mít epitaxní vrstva na různých místech v reaktoru např. různé složení,
tloušťku nebo být různě dotována. Z mísící hlavy směs laminárně proudí
do reaktoru k zahřívanému susceptoru, na němž leží substrát. Nad ním
dochází k tepelnému rozkladu plynů a jejich vzájemné reakci. Výsledkem je
depozice krystalograficky velmi kvalitní polovodičové epitaxní vrstvičky GaAs na GaAs
podložce. Sumární chemická rovnice vypadá docela jednoduše:
Ga(CH3)3 + AsH3 → GaAs + 3 CH4
Ve skutečnosti jde o složitou řadu procesů v heterogenním systému, kdy z plynných sloučenin vzniká pevná fáze. Jedna z těch jednodušších navrhovaných soustav reakcí popisující vznik pevného GaAs z plynných reaktantů Ga(CH3)3 a AsH3 může být následující:
| Termický rozklad TMGa | Ga(CH3)3 → Ga(CH3)2 + CH3 | (1) |
| Ga(CH3)2 → Ga(CH3) + CH3 | (2) | |
| H2 + Ga(CH3)2 → CH4 + Ga(CH3) | (3) | |
| Methylový radikál reaguje s arsínem což posouvá rovnováhu (1 a 2) doprava. |
CH3 + AsH3 → CH4 + AsH2 | (4) |
| A nakonec | AsH2 + Ga(CH3) → GaAs + CH4 + H | (5) |
Vzniká tedy GaAs, který epitaxně roste na substrátu a metan, který je spolu s H2
a ostatními nezreagovanými plyny odváděn do dvou reakčních kolon, kde se
většina plynných sloučenin oxidačně rozkládá a zůstává v roztoku.
Takto máme po přesně stanoveném čase připravenou vrstvu GaAs požadované
tloušťky. Chceme-li mít kvalitní rozhraní mezi vrstvou GaAs a následující
vrstvou, je nutné epitaxní růstový proces na několik vteřin přerušit a počkat,
až se směs plynů v reaktoru dokonale vymění. Přerušení epitaxního růstu se
provede uzavřením ventilů, kterými do reaktoru vstupuje TMGa. AsH3 spolu s
H2 musí neustále do reaktoru proudit. Kdyby totiž nebyl zajištěn stálý
parciální tlak AsH3 v reaktoru, došlo by při teplotě růstu k sublimaci As
z povrchu GaAs a monokrystalická podložka by rázem obsahovala mnoho krystalových
defektů. Po několika vteřinách se do reaktoru ke stále přítomnému AsH3
a H2 vpustí nová směs TMGa a TMAl. Z této směsi se analogicky vzniká
epitaxní vrstva AlGaAs.
x Al(CH3)3 + (1-x) Ga(CH3)3 + AsH3 → AlxGa1-xAs + 3 CH4
Pokud chceme dosáhnout n-typové nebo p-typové dotace epitaxních vrstev, musíme do směsi plynů při epitaxi přidat ještě nepatrné množství jiných vhodných prekursorů. Silan (SiH4) můžeme použít jako n-typový dopant pro vrstvy GaAs. Křemík Si se totiž při epitaxním růstu zabudovává na místa Ga v krystalové mříži a působí proto jako n-typová příměs. Silanu se však do směsi plynů připouští jen velice málo, v krystalu totiž musí být řádově asi 1 atom Si na 100000 atomů Ga a As. Jako p-typovou přiměs můžeme použít tetrachlormetan CCl4, který je zdrojem uhlíku. Uhlíkové atomy se zabudovávají na místa As a působí tak jako p-typová příměs.
 |
Znázornění fyzikálních a chemických procesů při MOVPE růstu polovodičové epitaxní vrstvy InAs na substrátu GaAs. |
Výhodou této technologie zejména při laboratorním využití je, že jedinou aparaturu lze použít pro přípravu širokého spektra polovodičů. Protože epitaxní růst neprobíhá za podmínek vysokého vakua, je příprava struktur levnější a rychlejší, nevýhodou je však, že pro diagnostiku epitaxního povrchu během růstu nelze použít vysokovakuové techniky odrazu elektronů. Pro tuto technologii byla proto vyvinuta nová optická metoda RAS (Reflectance Anisotropy Spectroscopy), která využívá různé povrchové odrazivosti polarizovaného světla v kolmých krystalografických směrech. Tato in situ metoda usnadnila kontrolu při přípravě náročných polovodičových struktur.
Vstupní látky jsou dodávány v nerezových probublávacích láhvích o objemu 250 až 2700 ml, nebo ve směsi s vodíkem nebo argonem v tlakových láhvích o objemu 5 až 10 litrů. Tyto plyny jsou po průchodu omezovací tryskou tlakově redukovány v plynotěsném proplachovacím redukčním ventilu a dále vedeny potrubím z nerezavějící oceli do aparatury, kde je jejich průtok měřen a nastaven na požadovanou hodnotu. Nosný plyn H2, čištěný difusí přes zahřáté palladium, pak průchodem přes nerezové tlakové probublávačky organokovových sloučenin, udržované na konstantní teplotě, unáší páry těchto sloučenin dále do aparatury. Všechny tyto plyny jsou vedeny do směšovací komory, a dále do reaktoru a odtud přes plynotěsnou rotační vývěvu do likvidační komory. Zde jsou zplodiny z reaktoru a nerozložené reaktanty převedeny na stabilní nízkotoxické látky.
Pomocí aparatury MOVPE AIXTRON 200 ve Fyzikálním ústavu AVČR jsou připravovány heterostruktury ze sloučeninových polovodičů GaAs, AlAs, InAs, GaSb, AlSb, InSb a jejích ternárních směsí, jako např. AlGaAs, InGaAs nebo GaAsSb. Kombinováním vrstev těchto polovodičů a jejich dotováním při epitaxi lze připravit pestrá škála polovodičových hetrostruktur. Na této aparatuře se připravují heterostruktury s kvantově rozměrnými prvky, kvantovými jamami, supermřížkami, ale především kvantovými tečkami, pro využití v aktivních oblastech laserových struktur a v detektorech.
|
Jedna z prvních MOVPE aparatur firmy Aixtron - AIXTRON 200: |
Kvantová jáma je vžitý, ale ne zcela výstižný termín. Vhodnější by v současné době bylo používat termín kvantová vrstva. Termín kvantová jáma se zažil v době, kdy se nepřipravovaly kvantové tečky ani kvantové dráty. Je to jen několik nanometrů tenká vrstva polovodiče, může být dokonce tvořena jen několika atomárními vrstvami. Jáma se jí říká proto, že je tvořena polovodičem s užším zakázaným pásem, než má materiál, který ji obklopuje. Elektronům resp. dírám se pak tato vrstva jeví jako potenciálová jáma ve vodivostním resp. valenčním pásu. Přívlastek "kvantová" získaly tyto vrstvy proto, že je jejich tloušťka srovnatelná s de Broglieho délkou elektronů a děr a nosiče náboje se proto chovají v těchto tenkých vrstvách podle zákonů kvantové fyziky: v rovině kvantové jámy se mohou pohybovat volně a mohou nabývat spojitě kinetickou energii, avšak ve směru kolmém, je jejich vlnová funkce kvantována, vlnový vektor k může nabývat jen určitých hodnot, a s tím souvisí také kvantování energie elektronů a děr do diskrétních hladin.
První fungující kvantová jáma byla připravena v kolektivu Raymonda Dingla v roce 1974. Díky svým vlastnostem se kvantové jámy nyní již běžně používají v moderních součástkách. V polovodičových laserech zvyšuje kvantová jáma zisk, účinnost, snižuje prahový proud a zlepšuje jeho teplotní stabilitu i monochromatičnost. Toto zlepšení polovodičových laserů usnadnilo jejich využití v mnoha aplikacích, např.ve čtečkách kompaktních disků při přenosu dat světlovodnými vlákny nebo v laserové spektroskopii. Kvantové jámy se také používají v součástkách s vysokými nároky na rychlost (HEMT -- z angl. High Electron Mobility Transistor), protože elektrony se mohou v kvantové jámě pohybovat s mnohem menším počtem srážek než v objemovém polovodiči. Tunelovací diody, ve kterých je kvantová jáma obklopena dvěma kvantovými bariérami, se využívají jako zdroje vysokých frekvencí.
Opakováním jámových a bariérových vrstev vznikají mnohonásobné kvantové jámy
(tlustší bariérové vrstvy), supermřížky (srovnatelná tloušťka jam a bariér)
nebo kaskády (proměnná tloušťka jámových a bariérových vrstev). Námi
připravované struktury se především používají v aktivních oblastech laserů.
Vyrobit kvantovou jámu však není jednoduché. Kromě toho, že vrstva musí být
extrémně tenká, jsou také kladeny vysoké nároky na kvalitu obou rozhraní, které ji
obklopují. Rozhraní musí být co nejrovinnější a přitom "ostrá",
musí se co možná nejvíce omezit mísení atomů obou polovodičů. V podstatě
existují pouze dvě technologie, pomocí nichž se běžně kvantové jámy připravují:
MBE a MOVPE.
V naší laboratoři MOVPE připravujeme polovodičové napnuté nanostruktury InAs/GaAs mnohonásobné kvantové jámy a supermřížky nebo InAsSb kvantové jámy s AlAsSb bariérami na GaSb podložce se střídáním stlačených a natažených vrstev. Všechny tyto struktury jsou používány v infračervených laserech s různou vlnovou délkou emise. Ze snímku části naší struktury s několikanásobnou kvantovou jámou (na obrázku) je zřejmé, že rozhraní epitaxních vrstev jsou rovinná a "ostrá". Snímek byl pořízen na lomu struktury InAs/GaAs rastrovacím tunelovacím mikroskopem na univerzitě ve švédském Lundu. Vidíme na něm jednotlivé atomy a můžeme určit tloušťku jámy -- přibližně 2 atomové roviny.
 |
 |
Snímek lomu násobné kvantové jámy
v atomárním rozlišení pořízený pomocí rastrovacího tunelovacího
mikroskopu. |
|
V kvantových jámách (vrstvách) se mohou elektrony a díry pohybovat volně ve 2 dimenzích, v jednom rozměru je jejich vlnový vektor kvantován. Pokud omezíme vlnovou funkci v dalším rozměru, a volně se tedy budou moci pohybovat nosiče náboje v jediném směru, získáme tzv. kvantový drát. Při omezení vlnové funkce ve všech třech dimenzích vznikne něco jako umělý atom, tzv. kvantová tečka. Přitom každý další rozměr omezující volný pohyb elektronů a děr představuje možnost výrazného zlepšení vlastností polovodičových laserů či jiných součástek např. pamětí.
Kvalitní kvantové tečky se poprvé podařilo připravit roku 1993 pomocí tzv. Stranskeho-Krastanovova módu růstu, při kterém se během epitaxe vytvářejí kvantové tečky samovolně následkem silného pnutí v heteroepitaxní vrstvě. Pnutí vzniká v důsledku velkého rozdílu v mřížkové konstantě podkladu a epitaxní vrstvy. Nejznámější systém pro přípravu kvantových teček je InAs/GaAs. InAs má o 7% větší mřížkovou konstantu než GaAs podložka. Při epitaxi InAs nejprve vznikne souvislá monoatomární tzv. smáčecí vrstva, při pokračování růstu vznikají na smáčecí InAs vrstvě kvantové InAs tečky čočkovitého nebo pyramidálního tvaru s výškou několika nanometrů a průměrem obvykle 10 -- 20 nm. Pro vznik kvantových teček v tomto systému je důležité, aby se ponechalo epitaxní struktuře dost času pro ustavení rovnovážného stavu. Růst musí proto probíhat velmi pomalu nebo musí dojít k jeho přerušení po růstu InAs před epitaxí krycí vrstvy.
Použití kvantových teček v polovodičových laserech přineslo výrazné více než dvojnásobné snížení prahové proudové hustoty na 19 A/cm2 a další snížení ztrát a zvýšení kvantové účinnosti. Podařilo se také podstatně prodloužit vlnovou délku emitovaného světla v systému InAs/GaAs až k 1300 a 1500 nm používané pro přenos dat světlovodnými vlákny. Struktury s mnohonásobnými kvantovými tečkami se využívají také v detektorech, které umožňují také kolmý dopad detekovaného záření. V budoucnu budou kvantové tečky využívány v DRAM pamětech, protože umožní extrémně krátké zapisovací doby, při dlouhých obnovovacích časech (o několik řádů delších, než v současnosti).
|
Odspodu substrát (GaAs), oddělovací vrstva (GaAs), smáčecí
vrstva s kvatovými tečkami (InAs), |
V laboratoři MOVPE ve Fyzikálním ústavu jsou připravovány kvantové tečky na bázi InAs/GaAs metodou Stranski-Krastanov. Jejich vlastnosti jsou optimalizovány pro využití v aktivních oblastech telekomunikačních laserů s vlnovou délkou 1300 a 1550 nm a pro využití v detektorech. Pro prodloužení vlnové délky do požadované oblasti jsou kvantové tečky překryty vrstvou ternární sloučeniny InGaAs nebo GaAsSb snižující pnutí mříže ve kvantové tečce. Pro využití v detektorech jsou připravovány násobné, vertikálně korelované struktury. Topografický pohled získaný pomocí mikroskopie atomárních sil (AFM) i příčné řezy zviditelněné pomocí transmisního (prozařovacího) elektronového mikroskopu (TEM) takovýmito strukturami jsou na následujícím obrázku.
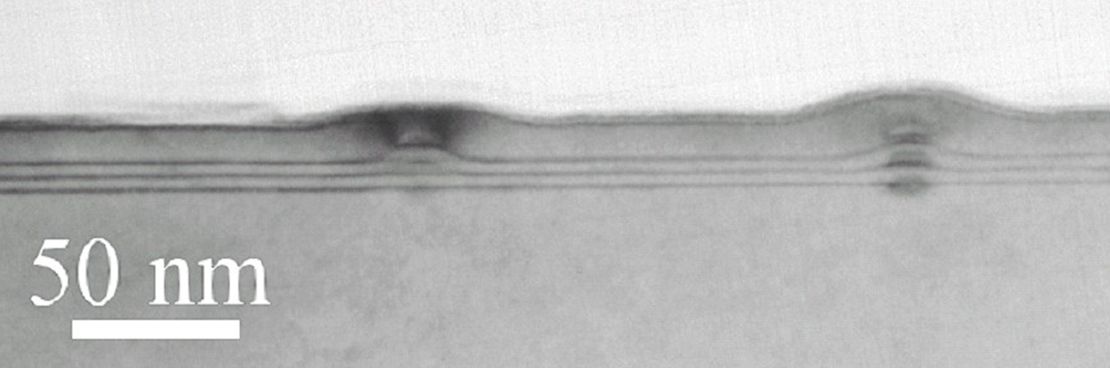 |
 |
| Snímek lomu trojvrstvých a sedmivrstvých kvantových
teček pořízený pomocí transmisního (prozařovacího) elektronového mikroskopu. |
|
Na vývoji, charakterizaci a studiu těchto struktur spolupracujeme s řadou českých i zahraničních pracovišť jako jsou Přírodovědná fakulta MU v Brně, Matematicko-fyzikální fakulta UK v Praze, Elektrotechnická a jaderná fakulta ČVUT Praha, Elektrotechnický ústav Slovenské akademie věd a IOFFE Institut v Petrohradu (Rusko), Laboratoř vysokého magnetické pole v Grenoblu (Francie), universita v Lundu (Švédsko) nebo univerzita ve Varšavě (Polsko).
Výchova studentů schopných tuto velmi složitou technologii v průmyslu používat v budoucnu i u nás, ale i studium prakticky významných struktur, dává perspektivu znovuvzkříšení moderní polovodičové výroby v ČR v oblasti špičkové technologie součástek s limitovaným odbytem nebo i součástek principiálně nových.(např. lasery pro vlnové délky nad 1,5 µm a pod.). Současně probíhá základní výzkum zatím komerčně nedostupných vrstev, struktur i součástek připravovaných z nových materiálů na bázi GaSb, InAs, které pracují na jiných fyzikálních principech.
Nedávno byla technologie MOVPE ve FZÚ doplněna o možnost in-situ (během růstu) monitorování tvorby polovodičových epitaxních struktur pomocí optické techniky RAS (Reflectance Anisotropy Spectroscopy) německé firmy LayTec. Standardní diagnostické metody pro vysokovakuovou technologii MBE využívající odraz elektronů (RHEED) nejsou totiž v plynné atmosféře uvnitř MOVPE reaktoru použitelné. Aby bylo dosaženo citlivosti na anizotropický dielektrický příspěvek povrchu, je měření RAS uspořádáno jako měření reflektance (reflexe) pro dvě vzájemně kolmé polarizace světla dopadajícího svisle na substrát. Proto se někdy místo RAS používá označení NIE (Normal Incidence Ellipsometry), vyjadřující podobnost s elipsometrickým měřením, které využívá poměr odrazivostí s- a p- polarizace světla poblíž minima odrazivosti při Brewsterově úhlu dopadu.
|
Pro přímé pozorování procesů při růstu se používá
reflektanční anizotropická spektroskopie (RAS). |
 |
| Grafické znázornění vztahu atomární struktury různých typů
povrchů arsenidu gallitého (GaAs) a příslušných RAS spekter, což jsou závislosti poměru odrazivosti polarizovaného světla na energii (vlnové délce) tohoto světla. |
Signál RAS, definovaný jako reálná část podílu anizotropické složky a celkové reflektance, je citlivý na úroveň dotace polovodičových vrstev, desorpci oxidů při ohřevu substrátů, ale i na růst nanostruktur s kvantovými tečkami. Z oscilací signálu odpovídajících vzniku jednotlivých monovrstev při ostrůvkovém růstu jsme navíc schopni velmi přesně určit jejich skutečnou tloušťku - v řádu nanometrů, viz další obrázek.
|
Záznam signálu RAS v čase během přípravy tenké GaAs
epitaxní vrstvy při teplotě 490 °C a energii fotonů 2.65 eV. |
Kromě přípravy struktur AIIIBV polovodičů epitaxí z
organokovových sloučenin a studia těchto polovodičových struktur je náplní práce
laboratoře i měření tenze par organokovových sloučenin. Přesná znalost tlaku par a
termodynamických veličin je nutná pro modelování růstů i vlastní experimenty. Byly
přesně změřeny tenze par organokovových sloučenin Li, Al, Ga, In, P, As, Sb, Si, Zn,
Fe, Ge, Mn, Mg, I, Zr, Hf, Er, Nd a Y.
Z historie laboratoře: